製造・検査装置
PLマッパー
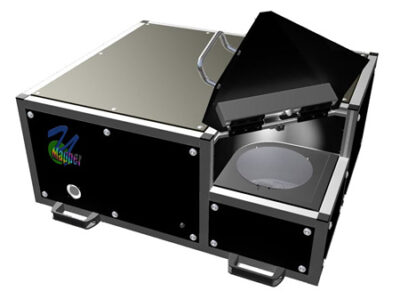
| 基本型式 | YWAFER-GS6 | YWAFER-GS6-RT | YWAFER-GS6-R | YWAFER-GS6-PL | |
|---|---|---|---|---|---|
| 光学範囲および感度型式一覧 | UVVIS: 280~850nm VISNIR: 350~1030nm UVNIR: 200~1100nm NIR: 900~1600nm (近赤外対応冷却InGaAsディテクタ) 540NIR: 540~1100nm (赤色高感度) UVNIR-HISENS: 200~1100nm (紫外高感度) |
||||
| 対応ウェハサイズ | 2、3、4、6インチ GS6-RDHLD: 1/4切断ウェハトレイ (オプション) GS6-2.5HLD: 2.5インチウェハトレイ (オプション) GS6-2x3HLD: 2インチウェハ×3 対応トレイ (オプション) |
||||
| ウェハ搬送 | 手動 | ||||
| マッピング間隔 | 0.04mm~(0.1mm 精度) | ||||
| 透過光による測定 | 測定項目 | 平均透過率 膜厚 (GaN膜厚換算) |
使用不可 | ||
| 精度 /再現性 |
1%以内 (0.5~50μmのGaN膜の場合) /10nm 以内 |
使用不可 | |||
| 反射光による測定 | 測定項目 | 使用不可 | 平均反射率 膜厚 (GaN膜厚換算) 表面の粗さ/拡散 DBR (分布ブラッグ反射鏡)特性 |
使用不可 | |
| 精度 /再現性 |
使用不可 | 1%以内 (0.5~50μmのGaN膜の場合) /10nm 以内 |
使用不可 | ||
| フォトルミネッセンス(PL)測定 | 測定項目 | ピーク波長/相対積分強度/相対ピーク強度/半値幅(FWHM) /主波長(CIE波長) |
|||
| 波長解像度 | ~0.3 nm (ただしUVNIR-HISENS では~0.7nm、NIR では~2.0nm) | ||||
| 光強度精度 | 3% (相対ピーク強度/相対積分強度・YWafer強度校正機能使用時) | ||||
| ピーク波長繰り返し精度 | < 1nm (ピーク波長/半値幅) | ||||
| 最小半値幅 | ~1.5 nm | ||||
| PL励起レーザー種類 (最大4台まで) |
266nm、325nm (外付・光ファイバー使用)、375nm、405nm、532nm 他応談 |
||||
| 制御 | 接続インタフェース | PC-based USB/デジタル I/O | |||
| ユーザーインタフェース/言語 | Microsoft Windows™ XP 搭載PC/日本語または英語 (ユーザー選択) | ||||
| 他オプション | GS-SPCFLT: 光減衰及び波長フィルタ制御 GS-LASFLT: レーザ強度フィルタ制御 GS-CUSTHLD: カスタムサンプルトレイ GS-TURBOSCAN: 高速スキャン対応 (PL測定のみ) |
||||
ソフトウエア
| バージョン | YWaferController v3.06 |
|---|---|
| プログラム言語 | マルチスレッド Visual C++ |
| オペレーションモード | オペレータ、エンジニア、メンテナンス |
| 特徴 | 内部干渉の影響を除去した再現性の高いスペクトル解析 |

性能
| ウェハあたり処理時間 | 手動ウェハ投入/取り出し | ~20 sec(オペレータ依存) | |
|---|---|---|---|
| 基準値(値の補正用)測定 | < 4 sec | ||
| 参考:2インチウェハ測定時 (min:sec) | |||
| 通常 | 高速(オプション) | ||
| 0.5mm間隔 (7429点測定) | 7:55 | 3:26 | |
| 1mm間隔 (1868点測定) | 2:34 | 1:02 | |
| 2mm間隔 ( 468点測定) | 0:51 | 0:31 | |
取り扱い仕様 (本体)
| 動作・設置環境 | 場所 | クリーンルーム(クラス 1000~10000)内 |
|---|---|---|
| 温度 | 15~35℃ | |
| 湿度 | < 85%RH (ただし結露しない条件) | |
| 寸法 | 縦540×横640×高さ300mm | |
| 重量 | 40 kg | |
| 入力電圧 | AC 100~240 V 50/60 Hz | |
| 消費電力 | 120W以下 | |
その他製造・検査設備/関連部品
- クレステック社製電子描画装置
- ワイシステムズ社製PLマッパー
- アルファクス社製LD検査分類機
- フォーテクノス社製ダイボンダ
- フォーテクノス社製ワイヤボンダー
- アルファクス社製LD温度特性検査機
- FTD社製調芯溶接装置
- UWJAPAN社製YAG溶接機
- 日本精線社製 半導体用ガスフィルター(NASclean®)
- テムテック研究所製圧力センサー
- インサーキットテスター(ICT)
【実装検査】 - 汎用ファンクションテスター(FCT)
【実装検査】 - ハンダ印刷検査装置(SPI)
【ハンダ印刷】 - 画像検査装置(AOI)
【実装検査】 - X線検査装置(MXI)
【実装検査】 - 画像+X線検査装置(AOXI)
【実装検査】 - メタルマスクレーザー加工装置
【ハンダ印刷】 - 部品実装データ作成支援システム
【部品実装】 - 搬送キャリア
【リフロー炉】 - 高耐熱両面粘着テープ
【リフロー炉】 - フラッシュマイコン・プログラマー
【実装検査】 - スピンスタンド(DTR3000)
- 高周波対応テストソケット
- 工業PC、計測・制御ボード
- 産業ネットワーク機器
- CableEyeテストシステム
- テスト治具基板
製造・検査設備/関連部品に
関するお問い合わせ
製品に関するご質問・ご商談等お問い合わせ
お問い合わせフォームお電話でのお問い合わせ
03-6412-6032
