Manufacturing and inspection equipment(中文)
PL图谱分辨仪
Manufacturing and inspection equipment(中文)
PL图谱分辨仪
标准配置
LED╱LD生产用光致发光及外延层厚度测量系统(适用于2、3、4、6英寸外延片)
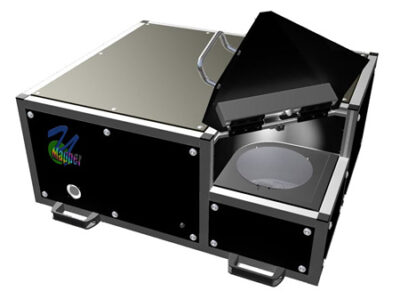
主机规格
| 基本型号 | YWAFER-GS6 | YWAFER-GS6-RT | YWAFER-GS6-R | YWAFER-GS6-PL | |
|---|---|---|---|---|---|
| 光学可测范围及灵敏度型号一览 | UVVIS: 280~850nm VISNIR: 350~1030nm UVNIR: 200~1100nm NIR: 900~1600nm (适用近红外线的冷却InGaAs检波器) 540NIR: 540~1100nm (红色高灵敏性) UVNIR-HISENS: 200~1100nm (紫外线高灵敏性) |
||||
| 载片尺寸 | 2、3、4、6英寸 GS6-RDHLD: 1/4截断外延片托盘(选配) GS6-2.5HLD: 2.5英寸外延片托盘(选配) GS6-2x3HLD: 2英寸外延片×3配套托盘(选配) |
||||
| 外延片传送方式 | 手动 | ||||
| 映像间隔 | 0.04mm~(0.1mm 精度) | ||||
| 透射测量 | 测量项目 | 平均反射率 外延层厚度(按GaN外延层厚度换算) |
不可使用 | ||
| 精度╱可重复性 | 1%以内(0.5~50µm的GaN外延层情况下)╱10nm以内 | 不可使用 | |||
| 反射测量 | 测量项目 | 不可使用 | 平均反射率 外延层厚度(按GaN外延层厚度换算) 表面粗糙度/分散 DBR(分布布拉格反射镜)特性 |
不可使用 | |
| 精度╱可重复性 | 不可使用 | 1%以内(0.5~50µm的GaN外延层情况下)╱10nm以内 | 不可使用 | ||
| 光致发光(PL)测量 | 测量项目 | 峰值波长╱相对积分强度╱相对波峰强度╱半值宽(FWHM)╱主波长(CIE波长) | |||
| 波长分辨率 | ~0.3nm(但在UVNIR-HISENS为~0.7nm,NIR为~2.0nm) | ||||
| 光强精度 | 3%(相对波峰峰强╱相对积分强度•YWafer强度校正功能使用时) | ||||
| 峰值波长反复精度 | < 1nm(峰值波长╱半值高) | ||||
| 最小半高宽 | – 1.5 nm | ||||
| PL激起激光种类(最大4台) | 266nm、325nm(使用外置光纤)、375nm、405nm、532nm 其它可协商 |
||||
| 控制单元 | 接口 | PC-based USB╱数码I/O | |||
| 运行环境╱语言 | 搭载Microsoft WindowsTM XP的PC╱日语或英语(用户选择) | ||||
| 其它选配项 |
GS-SPCFLT : 光衰减及波长滤波器控制 GS-LASFLT : 激光强度滤波器控制 GS-CUSTHLD : 用户样品托盘 GS-TURBOSCAN :高速扫描(仅测PL) |
||||
软件
| 版本 | YWaferController v3.06 |
|---|---|
| 程序语言 | 多线程Visual C++ |
| 操作模式 | 操作员、工程师、维护 |
| 特点: | 清除了内部干涉影响,具有高度再现性的光谱分析。 |

性能
| 每张外延片的处理时间 | 手动装片╱卸片 | -20 sec (依赖于操作熟练程度) | |
|---|---|---|---|
| 标准值(测量值校正用)测量 | < 4 sec | ||
| 参考:测量2英寸外延片时(min:sec) | |||
| 通常 | 高速(选配) | ||
| 0.5mm间隔(测量7429点) | 7:55 | 3:26 | |
| 1.0 mm间隔(测量1868点) | 2:34 | 1:02 | |
| 2.0 mm间隔(测量468点) | 0:51 | 0:31 | |
操作规范(主机)
| 运行、设置环境 | 场所 | 无尘室(1000~10000级)内 |
|---|---|---|
| 温度 | 15 – 35℃ | |
| 湿度 | < 85%RH (要求不结露) | |
| 尺寸 | 纵向540×横向640×高度300mm | |
| 重量 | 40 kg | |
| 输入电压 | AC 100~240 V 50/60 Hz | |
| 消耗电力 | 120W以下 | |
Other Manufacturing and testing equipment & parts products
For inquiries about Manufacturing and inspection equipment for laser diodes
For inquiries about our products and business negotiations
Contact by formContact by phone
+81-(0)3-6412-6032